パワーアンプ (電力増幅器) ~通信機のキーデバイス~あらゆるものをワイヤレスでつなぐ 第4回

パワーアンプ(以下PA)とは高周波信号の送信系に用いるアンプです。高周波信号に変換されたデータ通信信号を歪ませることなく、アンテナから電波として放射できるレベルまで増幅させることがPAの役割です。
アンテナから放射する電波は、電波法で使える周波数だけでなく電力レベルや他チャンネルへの影響を最小限にするよう規定されています。この法令に適合できるように、歪ませない(他チャンネルへ影響させない)ことが重要です。 また出力する電力レベルは携帯電話などでは1Wクラスになり、半導体で扱うには非常に大きな電力となります。スマートフォンなどでは、液晶ディスプレイの次にバッテリーを消費させる部品となります。そのため出来るだけ電力を消費しない、効率の高いPAが求められます。
デバイス
かつてのPAはMES FETのディプレッション型FETを用いたものが主流でした。ディプレッション型とはノーマリオン特性を持ち、ゲート・ソース間電圧が0Vの時にドレイン・ソース間に電流が流れます。従って、ソース電位よりゲート電位を低くすることでドレイン・ソース間電流を遮断する(ピンチオフ)特性をもつことが可能となります。増幅器として動作させるためには、ソース電位を0Vより高く設定し、相対的にゲート電位をソース電位より低くしてピンチオフさせる使用方法があります。このようなソース電位を持ち上げる以外の方法としては、ゲートに負電圧を印加する方法があります。しかし、ゲートに負電圧を印加するには、外部から負電圧を用意するか、負電圧発生回路を設ける必要があります。
当時、当社では負電圧発生回路をシリコンCMOS半導体チップで、PAをGaAs半導体チップで用意し、それぞれをひとつのパッケージに封止する方法で、PA製品を実現していました。
GaAs半導体の歴史(当コラム第2回)でも触れましたが、当社では2000年代にHBTが実用化されました。当社ではこのHBTを用いたPAをPHS向けのフロントエンドIC(高周波スイッチ、パワーアンプ、ローノイズアンプ、ミキサーの複合IC)に搭載しました。その後のPAの開発では、このHBTのデバイス特性をブラシュアップしながら使用しています。
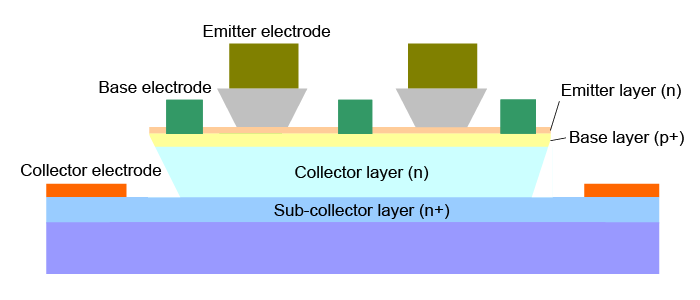
第2回より、GaAs HBT (Hetero-Junction Bipolar Transistor)
PA設計
PAの高出力化はトランジスタサイズの拡大と、パワー合成という技術で高い出力を実現することが可能です。しかし、この高出力化と並んで歪特性、消費電力が重要な特性となります。
-
歪特性はACLR(隣接チャンネル漏洩電力比)やEVM(エラーベクトル振幅)といった特性値で、消費電力の指標はPAE(電力付加効率)と呼ばれる特性値で表されるのが一般的です。
これらのACLRおよびEVM、PAEはPAの出力の負荷インピーダンスを調整することで、それぞれにとって最適な条件が存在します。図1はPAの簡単なブロック図です。このPAの出力側のインピーダンス整合と負荷インピーダンスを決める回路に特性調整の要素があります。
-
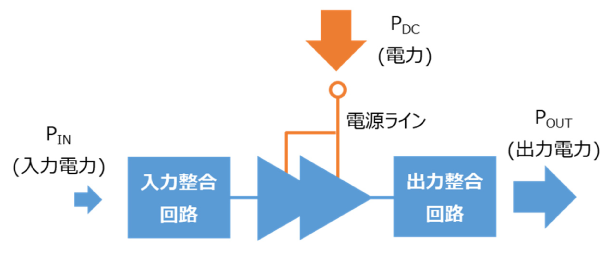
図1. PAブロック図
負荷インピーダンスも使用する帯域だけでなく、2次高調波、3次高調波のインピーダンスまで最適な状態に調整することで、高効率で低歪なPAを実現することができます。
図2はインピーダンスを示すスミスチャートの一例で、黒点は周波数帯域を表しています。2次高調波インピーダンスはオープンに近く、3次高調波インピーダンスは2次高調波インピーダンスよりショートに近い点にあり、それぞれの周波数に最適なLやCを接続して実現します。
このインピーダンスの調整は非常にシビアな調整であり、微小なキャパシタンスやインダクタンスの変化でも特性に影響を与えます。PAはこのような針の穴を通すような調整が必要であり、ノウハウと経験が生きる設計となっています。

図2. インピーダンスを示すスミスチャートの一例
このようなシビアな出力負荷を精度よく実現するためにも、出力整合回路を内蔵したモジュール化が市場からの強い要求となりました。また携帯電話などで多数の帯域に対応するには、それぞれの帯域に最適化したHBTと負荷回路が必要になります。当社ではHBTと負荷回路およびコントロールICを1つのパッケージに収めたPAM(PA Module)を開発・販売しています。
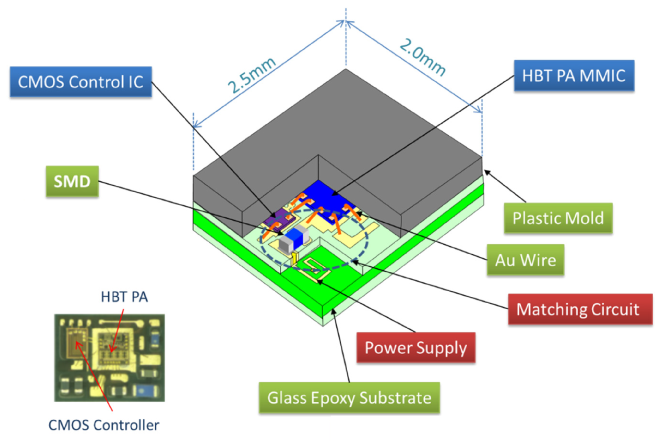
図3. PAM(PA Module)
パッケージ
PAでは小さなチップのなかで1W以上の消費電力が生じることから、いかに動作状態で生じた熱をパッケージの外部に逃がすかといった、熱設計も重要な設計要素になります。このような熱設計としてリードフレームのパッケージでは、裏面露出パッドが必須で、さらに内部のチップとの接合に用いるペースト剤やチップそのものの厚さも重要です。また樹脂基板を用いたモジュールでは熱抵抗を低減させるようにチップ裏面からパッケージ裏面につながる埋め込みスルーホールが必須になります。 このようにPAで用いるパッケージは、他の製品とは異なった観点での材料選定が必要であり、技術の蓄積が極めて重要となります。
まとめ
アンテナから放射される高周波信号に直接かかわるPAは、電波法等に従った各通信方式の規格の遵守が必須で、さらに非常に優れた性能が求められるため、高度な技術の結晶といっても過言ではありません。日清紡マイクロデバイスでは20年以上の開発経験を有しており、小回りの利いた部品を提供することで通信業界の一端を支えています。
(第5回につづく)
2023年7月11日公開
執筆者プロフィール
-

紫村 輝之
30年以上、日本の化合物半導体の発展に携わり、特にGaAs系HBTの開発に情熱を注いだことで、業界内でも 名が知られた存在。当社ではパワーアンプ開発を主導。工学博士(通信工学)。
-

加藤 岳
当社RFデバイスで20年以上の製品設計に従事。世界最高レベルの低雑音を実現したLNA等を開発。お客様に喜ばれる小回りの利く製品開発をモットーとして、特出した製品の創出に日々精進している。本Webコラムの代表者。







